
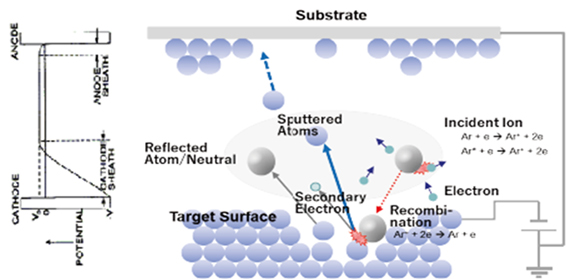
High-energy residual emission and collision/ionization with neutral gas
Ion acceleration due to positive bias near the target / Collision with the target and transferring momentum through the cathode sheath → Total bias (Vp-Vc): 200 ~ 1000eV by IV characteristics
Target leaving the lattice and moving to the substrate: 3~10eV
Secondary electron emission and self-discharge are maintained when ions collide with the target.
Collision of electrons with surrounding gas, generation of radical and negative ions / Impact of acceleration material along the anode sheath
Condensation and thin film formation on the surface of the released target particles
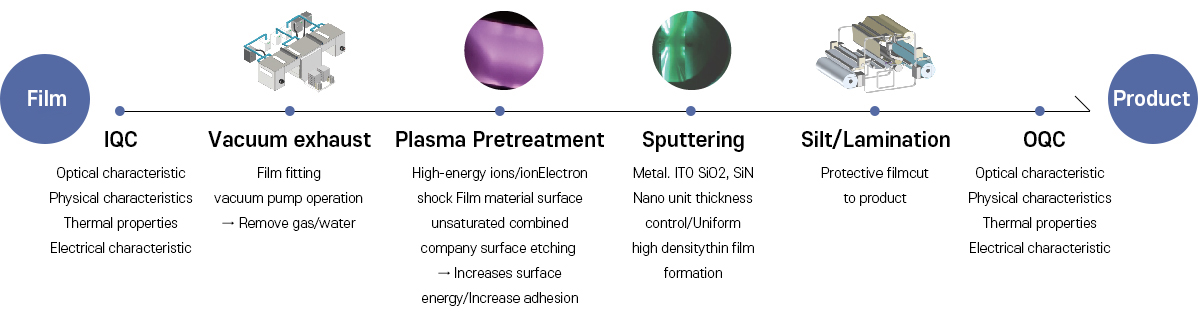

| Effective Width | 400m less then |
|---|---|
| Film Thickness | 25㎛ or more |
| Roll Diameter | 500m |
| Pretreatm ent | Plasma Pretreatm ent |
| Cathode | 1(Single)ea + 1(Dual)ea |
| Sputter Power | DC 1ea + MF 1Set |
| Heating System | IR-Heater / Drum |
| Deposition effective width | 1500m |
|---|---|
| film thickness | 1500m |
| Film roll diameter | 3000m |
| Installed film length | 3000m |
| film length | < 5.0E-5Pa |
| maximum vacuum | < 5.0E-4Pa |
| Reach input | Plasma treatment (ea) |
| speaker device | 6(Single)ea+1(Dual)ea |
| speaker power | MF(1)ea / DC(6)ea |
| Giza heating device | IR Heater / Drum |
| vacuum pump | Dry Pump+B |
| Four Cold | |
| vacuum chamber | drum/water |
| Film substrate driving device | |
| Plasma pretreatment | |
| TMP / Cryo coil | |
| Sputter device | Cathode (dual) |
| Power output device | |
| Gas supply control |